2025 半導體挑戰驟增,AI 如何引領 IC 封測快速邁向新階段?

半導體晶片與積體電路(IC)產業作為全球科技創新的核心,涵蓋處理器、記憶體、感測器與光電顯示技術等多項關鍵領域。隨著 5G 網路逐步普及、大規模 AI 計算需求攀升,加上物聯網設備的加速擴展,市場對更高效、更輕薄的晶片需求持續升高,也進一步推動晶圓製造、先進封裝、新型半導體材料等製程技術不斷突破,使晶片成為產業加速發展的重要推力。
尤其是在人工智慧與電動車兩大領域共同推升高階晶片需求的背景下,晶片製程複雜度持續攀升,價格波動更趨劇烈,「如何提升良率、壓低成本」成為半導體企業普遍焦慮的事情。無論是傳統封裝、先進封裝、新型半導體材料,或晶圓製造各環節的品質穩定與優化,每一道製程的微小誤差,都可能造成動輒數百萬至數千萬元的損失。
2025 年,誰能率先調校量產製程參數、加速新產品開發與產能爬坡,就能搶先掌握市場主導權,取得下一代產品的市場商機。而這些關鍵答案,其實就藏在企業現有的歷史資料之中。
半導體市場回溫:亞太區持續領跑,台灣穩固價值鏈關鍵地位
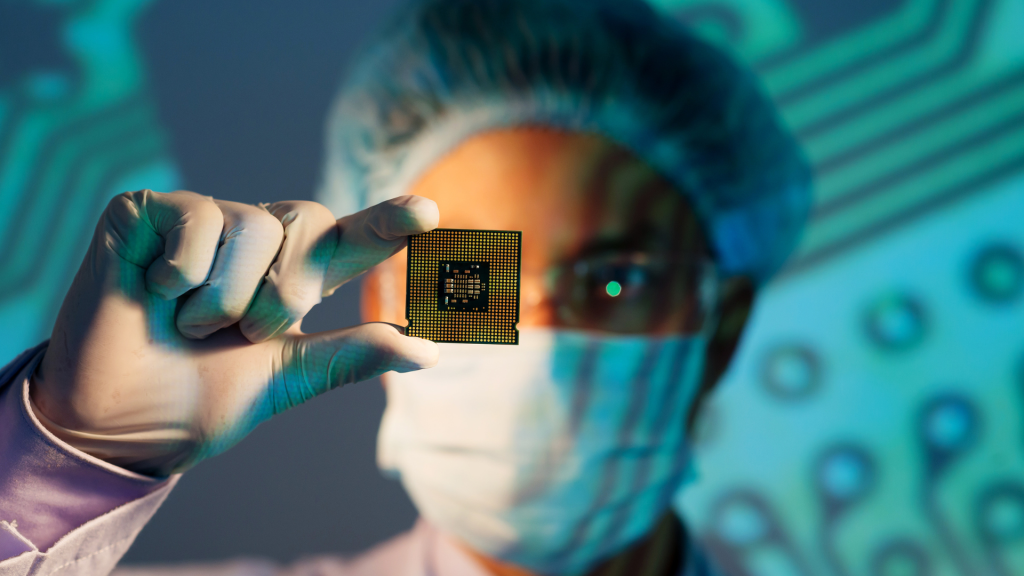
根據世界半導體貿易統計組織(WSTS)最新預測,在高階晶片與記憶體需求推動下,2025 年全球半導體市場規模可望達到 6,970 億美元,較去年成長約 11.2%。Fortune Business Insights 的研究指出,亞太地區以 50.94% 的市場占比穩居全球首位。
其中,台灣憑藉成熟的半導體供應鏈與全球領先的先進製程能力,持續在國際半導體價值鏈中扮演關鍵角色。尤其在先進晶圓製造、晶圓代工與先進封裝方面展現深厚技術累積與量產優勢,成為全球科技供應鏈穩定與韌性的核心支撐力量。
解析半導體四大製程挑戰,提前搶佔市場份額的關鍵

AI 技術與電動車等新興應用的快速發展,為記憶體技術(如 HBM、3D DRAM)及先進 IC 封裝技術帶來全新的成長契機。此外,碳化矽(SiC)與氮化鎵(GaN)等半導體新材料,也將在這些領域扮演關鍵角色。這些技術的突破不僅能提升半導體產品的效能與效率,更可為自動駕駛、智慧城市與高效能運算等應用帶來全新市場需求。
儘管半導體產業需求持續強勁,市場仍面臨多元且層次不同的挑戰。根據 KPMG 的分析,關稅議題被視為未來三年內半導體產業最大的不確定因素之一。隨著國際政治情勢與貿易政策變動加劇,相關衝擊可能進一步影響供應鏈穩定與成本控管。為了因應這些挑戰,企業勢必提高供應鏈韌性,不僅是維持競爭力的關鍵,更是面對製程瓶頸與成本壓力的重要策略。
除了外部市場環境的挑戰外,半導體產業在製程技術上同樣面臨一系列難題。以下列出當前半導體業所面臨的幾項主要挑戰:
1. 新材料測試週期長,參數優化效率低
隨著新興技術快速演進,市場對更高效、更小型的半導體產品需求持續攀升。傳統材料(如銅、矽)逐漸無法支撐高性能應用,也促使產業加速導入新材料(如二維材料、氮化鎵、氮化矽等)以滿足更嚴苛的效能要求。
然而,新材料研發與測試週期普遍冗長,且多仰賴關鍵參數點進行初步驗證,資料有限、最佳化空間受限。更關鍵的是,新材料導入往往需同步搭配全新製程技術,使整體研發週期更漫長、實驗流程更複雜。一旦在關鍵製程突破上較競爭者慢半拍,企業即可能錯失市場時機、無法快速響應需求變化,最終削弱競爭力。
2. 晶片封裝調參繁瑣,Golden Recipe 難以複製
隨著晶片尺寸持續縮小,同時對運算效能與功耗要求大幅提升,散熱便成為半導體封裝階段的一大技術挑戰。特別是在高密度整合架構下,各項製程參數需被精準調校,才能確保產品維持效能、穩定度與壽命。
以傳統封裝的焊線鍵合(Wire Bonding)製程為例,機台差異、製程參數設定、設備狀態或環境條件(如溫度、濕度)等任一變動,都可能使生產品質出現波動。若無法事先預測新批次參數下的品質結果,往往只能在異常發生後再回頭分析,並依賴工程師經驗與多次試錯修正,不僅耗時費力、成本高昂,也可能造成量產延遲或品質不穩定風險。在競爭加劇的市場中,能否提前預判品質趨勢並快速調參已成為關鍵分水嶺。若反應速度不及,企業便可能錯失搶占市場的先機,進而落後於競爭者。
3. 微凸點(Bumping)調參空間小,良率難以突破
在扇出型晶圓級封裝(FO-WLP)、倒裝芯片(Flip-Chip)以及 3D 堆疊等先進封裝製程中,微凸點(Bumping)間距已縮小至 30 μm 以下,對下方催化金屬層 UBM 膜厚、電鍍均勻性、光刻開槽深度及回流焊(Reflow)窗口皆提出了亞微米級的製程控制要求。
由於調參空間極為有限,任一細微偏差均可能導致 Bump 傾斜、空洞、潤濕不良等缺陷,進而影響訊號完整性與封裝可靠性。過往的製程優化主要依賴 DOE + 試錯方式,往往需進行數十輪迭代才能收斂。然而,在先進封裝產線加速導入 HBM 與 Chiplet 的量產競速壓力下,此種方式的響應速度已難匹配量產節奏。
若無法快速鎖定最佳參數組合、顯著提升良率與性能,便可能在下一輪晶片封裝競賽中失去先機。
4. 封裝/晶圓級翹曲與熱應力管理難度大
隨著矽穿孔(TSV)、多層重佈線層(RDL)與封裝模塑複合材料的異質整合愈趨普遍,材料間熱膨脹係數(CTE)差異所帶來的影響也愈加明顯,封裝/晶圓級翹曲正逐漸成為製程中的主要挑戰。翹曲不僅可能造成 RDL 對準偏移,更會在回流焊與溫度循環測試階段拖累良率表現。即便具備線上位移監測,多數情況仍屬於事後補償、被動處理,也因此推高製造成本。
目前缺乏能高效率支援製程優化與數據分析的工具,使良率波動難以徹底改善,可靠度風險亦持續存在。一旦產品品質不穩、製程效率不達標,不僅會影響量產節奏,更可能在市場競速中錯失佈局時機,競爭力瞬間拉開差距。
從經驗到模型:AI 讓製程調參可複製、可持續進化

儘管半導體產業正面臨多重挑戰,包括新材料導入、封裝製程參數調校以及晶片可靠性門檻不斷提升,加之全球主要經濟體之間的關稅壁壘,產業承受的壓力可謂前所未有。
Profet AI 面向高端製造業打造的 AI 平台 Domain Twin™(領域知識分身),以三大標準化產品模組與兩大實施方法論為核心,並可支持企業於工廠環境中私有化落地部署,加速 AI 能力在製造現場的導入與複製。
其中,「AutoML 無代碼機器學習平台」,專為結構化數據設計。使用者僅需匯入包含製程參數與品質結果的歷史數據,即可在無需撰寫任何演算法、程式碼的情況下,透過五步驟完成設置並自動訓練生成預測模型。同時,結合 Profet AI 的方法論 AI Thinking Workshop,透過互動式情境討論與手把手實務引導,協助製程與品質工程師快速建立 AI 問題拆解邏輯與應用思維,並帶來以下核心效益:
- 快速識別影響製程的關鍵因子:透過對歷史資料的分析,AI 能在短短數十分鐘內,從大量且複雜的特徵中迅速辨識影響目標結果的關鍵因素,大幅縮短過去研究人員常需耗費數小時甚至數天才能完成的參數收斂過程,而不再只能仰賴經驗判斷或推測。
- 提前預測生產的品質結果:透過 AI 模型提前預測生產的品質結果,判斷當前製程參數組合是否可能導致缺陷或不良品的發生,以結果預測進行決策輔助,及時調整避免損失,而非過往只能當不良發生之後,才進行事後復盤,導致生產成本已經增加,沒辦法降低耗損。
- 設定期望目標,找出最佳的參數組合:基於歷史資料建立的 AI 模型,設定目標的期望值,快速推薦接近理想目標的製程參數,減少反覆的試錯過程、設備調整參數的時間,更大的幫助在於縮短資深員工與新進員工的經驗差距,幫助新進人員快速上手。
某知名半導體 IC 封測 A 公司在導入 Profet AI 平台和方法論後,在先進封裝和傳統封裝上,展現加速參數最佳化後所帶來的品質提升與成本下降效益,例如:在晶圓研磨(Back Grinding)當中,避免了成功因不良 Ra、TTV 過大導致的返工,平均提升生產良率 2% 至 5%;在晶粒貼合(Die Bonding / Die Attaching)當中,良率提升 1.5% 至 2.2%,首件良率提升 10%,同時減少重工返修的時間和成本;在晶片成品測試(Final Testing)當中,品質結果提升 2.4% 至 2.6%,同時減少人力的找查與分析的時間成本約 16%。
因此,在半導體 IC 封裝與測試中,無論是傳統封裝或先進封裝,每個製程都有相對應的 AI 議題,如何清晰的定義 AI 命題、合理的將資料建立 AI 預測模型,再利用工程領域思維對模型結果進行解讀,並構思實際部署落地在工作流程的機制,這樣不僅可以節省大量時間和人力成本、提升產品生產的良率,更是提前搶佔量產時機的關鍵要因,同時落實經驗資產化和預判標準化。
想進一步了解 AI 在半導體製造中的實際成效?
填寫以下表單,即可領取 Profet AI 精選的半導體應用案例,涵蓋晶圓拋光、化學材料與封裝等上中下游關鍵製程,讓您快速掌握 AI 如何提升良率穩定性。